Microscopía de Fuerza Atómica (AFM)
La Microscopía de Fuerza Atómica (AFM) es una técnica de medida superficial que se basa en la interacción de una punta afilada situada en el extremo de una palanca flexible con la superficie de la muestra manteniendo constante una pequeña fuerza de interacción. El barrido lo realiza un escaner piezo-eléctrico, y la interacción punta/muestra se monitoriza reflejando un láser en la parte trasera de la palanca, que se recoge en un detector fotodiodo. El fotodiodo está dividido en 4 segmentos, y las diferencias de voltaje entre los distintos segmentos (generalmente los 2 superiores respecto de los 2 inferiores) determinan con precisión los cambios en la inclinación o amplitud de oscilación de la punta.
Esta técnica permite el análisis superficial de muestras con resolución nanométrica o incluso atómica. Como principal ventaja tiene la posibilidad de hacer medidas sin ningún tratamiento previo de la muestra a medir, y sin la necesidad de emplear vacío.
- Microscopio AFM Nano-Observer de la marca Concept Scientific Instruments.
- Microscopio Raman Confocal- Microscopio Fuerza Atómica (AFM) modelo Alpha300R – Alpha300A AFM Witec.
El equipo combina las potencialidades de un Microscopio de Fuerzas Atómicas (AFM), con las potencialidades para la caracterización composicional y estructural de materiales a escala submicrométrica que permite la Espectroscopia Raman Confocal.
En nuestro servicio se dispone de los siguientes modos de trabajo:
- Topografía en modo contacto, en aire y en líquido mide la topografía deslizando la punta sobre la superficie de la muestra (medidas de rugosidad superficial, altura de capas, escalones, terrazas o la forma o distribución de objetos en la superficie)
- Topografía en modo tapping, en aire y en líquido. Mide la topografía tocando intermitentemente la superficie de la muestra con una punta oscilante. Se eliminan las fuerzas laterales y de presión que pueden dañar las muestras blandas y reducir la resolución de la imagen. Se puede realizar en aire y en medio líquido.
- Imagen de Fase: Proporciona imágenes cuyo contraste está causado por diferencias en las propiedades de adhesión y viscoelasticidad de la superficie de la muestra. Se realiza en modo Tapping y se mide como el retraso en la fase de oscilación de la punta medido en el fotodiodo, con respecto al valor de fase de oscilación proporcionado por el piezo del soporte de la punta.
- Medidas mecánicas, tanto en contacto como en tapping, y en aire o en líquidos (obtención de curvas deflexión-desplazamiento).
- Medidas de potencial de superficie que permite detectar la presencia de cargas en la superficie de la muestra.
- Medidas de fuerzas magnéticas (MFM) mide el gradiente de distribución de fuerzas magnéticas por encima de la superficie de la muestra, permitiendo observar dominios magnéticos que no son visibles en el modo topográfico.
- Medidas de fuerzas eléctricas (EFM) sobre la superficie de la muestra.
- Medidas de nanoindentación y nanoscratching para obtener información sobre la dureza de una muestra o la adhesión y durabilidad de una película.
Esta técnica ha sido esencial en el desarrollo de la nanotecnología para la caracterización y visualización de materiales a dimensiones nanométricas, con lo que tiene aplicaciones en multitud de ámbitos científicos: física, ciencia de los materiales, caracterización de materiales orgánicos e inorgánicos, polímeros y materiales compuestos, microelectrónica, ingenierías, química, capas finas (análisis de rugosidad superficial), biología y medicina (obtención de imágenes tridimensionales de proteínas, ADN etc.).
El equipo de WITEC es mixto ya que puede funcionar asociado a nuestro equipo de Microscopía Confocal RAMAN y que permite la adquisición de RAMAN mediante el efecto TERS de las puntas del AFM.
Pedidos de ensayos desde la plataforma INFRARED
Galería multimedia

AFM-RAMAN confocal
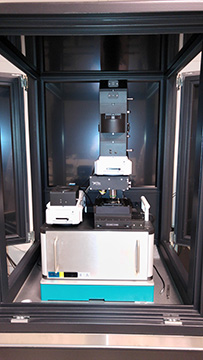
AFM-RAMAN confocal
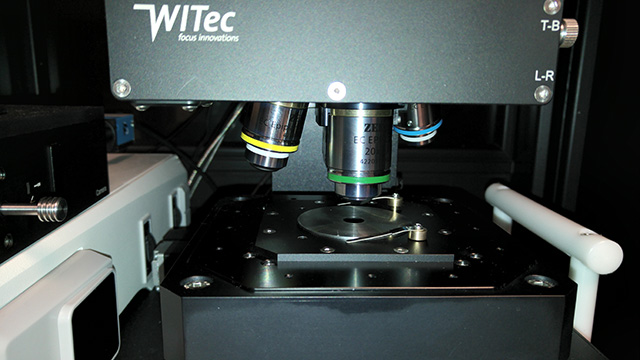
AFM-RAMAN confocal

AFM-NANO

AFM-NANO
Última actualización: 22 de Abril de 2025




